国产失效分析设备制造商致晟光电!热点定位两项关键技术详解
在半导体失效分析的全流程中,失效点(热点)定位是连接 “现象观察” 与 “根源分析” 的关键环节。 此前 我们梳理了 芯片 失效分析的完整流程,而这一流程能否高效推进,核心在于能否从复杂的器件结构中精准锁定热点 —— 它不仅决定了后续分析的方向,更直接影响产品良率提升与可靠性优化的效率。致晟光电深耕光学失效定位领域, 通过自主研发 核心设备( Thermal 热红外显微镜 、 EMMI 微光 显微镜 ) 构建了覆盖不 通 失效场景的热点定位解决方案,从原理到性能实现全方位技术支撑。
热点定位的核心光学手段
在电性失效分析(EFA)领域,光学失效定位因 “非接触、无损、高精准” 的特性成为主流选择,其中Thermal、EMMI、OBIRCH是应用最广泛的三大技术。三者基于不同的物理原理,覆盖了从 “热信号”“光信号” 到 “电阻变化信号” 的多维度检测,而分辨率与检测对象的适配性是其核心差异点:
分辨率层面:Thermal与 EMMI、OBIRCH均能实现微米级定位 —— 制冷型 Thermal 极限分辨率达2μm,非制冷型达5μm;EMMI在 100X物镜下分辨率为0.4μm,可捕捉更细微的热点;OBIRCH依托激光扫描精度,同样能实现微米级定位。
检测对象层面:Thermal擅长捕捉 “微弱热信号”(如隐性漏电的低热辐射),EMMI专注于 “光子发射相关的电失效”(如PN 结漏电的光子辐射),OBIRCH则针对 “电阻变化相关的缺陷”(如线路断路、接触不良)。
三者协同配合,可覆盖半导体器件从表层到内部、从显性到隐性的几乎所有热点定位需求。
致晟光电两大核心设备:原理与优势详解
Thermal 热红外显微镜P系列

热红外显微镜(Thermal)是致晟光电在热点定位领域的核心技术之一,其核心优势在于对 “微弱、隐性热信号” 的超高灵敏度检测,尤其适合传统热成像无法识别的低功耗失效场景。
从原理来看,该系统依托 “锁相放大技术” 实现了热信号的 “精准提取” 与 “维度拓展”。检测时,系统会对待测器件施加周期性(Lock-in)电信号,使器件表面的热辐射随电信号产生同步周期性变化 —— 这些变化的热辐射被红外相机捕捉后,会生成两类关键图像:一是 “热幅值分布图”,通过热信号强度差异直接定位热点位置;二是 “相位图”,通过热点热信号被检测到的时间延迟,反推热点在器件内部的深度(延迟越大,说明热点位置越深)。
这种技术设计带来了两大突破:一方面,我们通过对RTTLIT锁相分析系统的优化,其温度检测灵敏度达到 “微 K(μK)” 级别,相比传统稳态热成像提升2-3 个数量级(相当于从 “能看到燃烧的火焰” 升级到 “能感知烛火的温度波动”);另一方面,结合致晟光电的显微光学设计,制冷型Thermal 的极限分辨率达2μm,非制冷型达5μm,既能捕捉芯片表面的微米级热点,又能通过相位图区分表层与内部缺陷(如芯片封装下的引线键合不良与内部栅极漏电)。
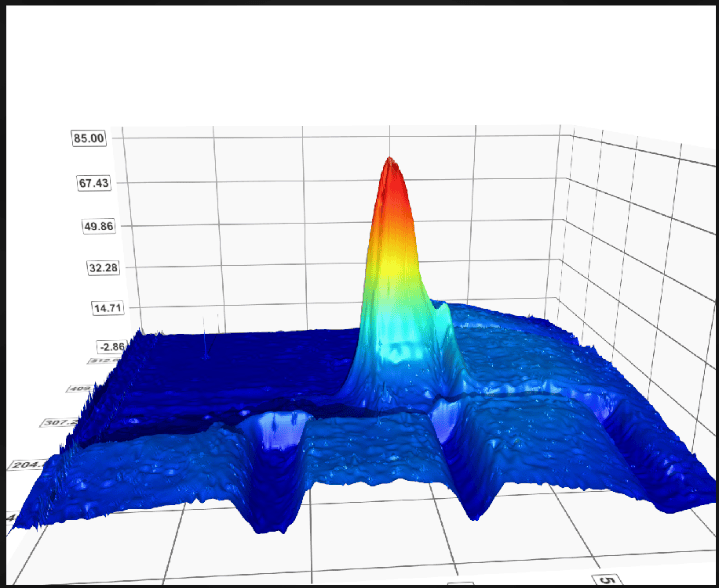
在应用中,它尤其适合检测 “低热耗失效”—— 如半导体器件的微弱漏电(功耗低至1μW)、IGBT模块的局部隐性过热、第三代半导体材料的晶格缺陷导致的热分布异常等,这些场景下的热信号往往被环境噪声掩盖,而Thermal 的锁相技术能像 “信号滤波器” 一样排除干扰,实现精准定位。
EMMI 微光显微镜 E系列

如果说Thermal 聚焦 “热信号”,那么 EMMI光发射显微镜则专注于 “光子信号”—— 通过捕捉半导体失效时产生的光子,实现对电缺陷的直接定位,是PN 结漏电、氧化层崩溃等失效场景的 “金标准” 设备。
其核心原理基于半导体失效的 “光子发射机制”:当半导体器件存在缺陷(如漏电、氧化层击穿)并施加电压时,会通过两种方式产生光子 —— 一是电子 -空穴对复合释放能量(以光子形式辐射),二是热载子释放多余动能(转化为光子)。这些光子波长多在近红外波段(900nm~1700nm),恰好被EMMI 的高灵敏度探测器(如InGaAs 相机)捕捉,最终形成 “热点图像”(Hot Spot)。
致晟光电EMMI 系统的优势在于 “高分辨率” 与 “宽适用性”:100X物镜下0.4μm的分辨率,能清晰识别芯片内部微小结构(如栅极、PN结)的光子发射;而针对不同失效机制的适配性(如接面漏电、静电放电破坏、闩锁效应等),使其成为 “一站式光子信号检测平台”。例如在检测芯片静电放电(ESD)损伤时,EMMI能通过捕捉损伤区域的光子发射,精准定位到被击穿的氧化层位置,这比传统电学检测更直观、更快速。
协同定位:致晟光电的 “场景化解决方案”
Thermal、EMMI、OBIRCH虽原理不同,但在实际应用中形成了互补的 “技术矩阵”:检测芯片漏电时,可先用Thermal 通过热信号锁定大致区域,再用EMMI 捕捉光子信号精准定位漏电点;分析线路缺陷时,OBIRCH可直接定位断线位置,搭配Thermal 的热分布验证缺陷对器件发热的影响。
致晟光电正在通过硬件集成与软件协同,让目前两款设备实现了 “数据互通”—— 例如Thermal 的相位图与EMMI 的光子图像可叠加分析,明确热点深度与光子发射的对应关系;未来OBIRCH的电流变化数据可与Thermal 的热信号关联,验证缺陷对器件功耗的影响。这种 “多维度验证” 的能力,让热点定位从 “单一信号检测” 升级为 “多信号交叉验证”,为后续失效根源分析提供更全面的依据。
从技术本质来看,致晟光电的三大设备不仅是 “检测工具”,更是半导体失效分析的技术桥梁—— 它们以精准的热点定位为起点,连接起器件设计、生产制造与可靠性测试的全链条,最终助力半导体行业从 “发现问题” 走向 “预防问题” 的技术升级。
